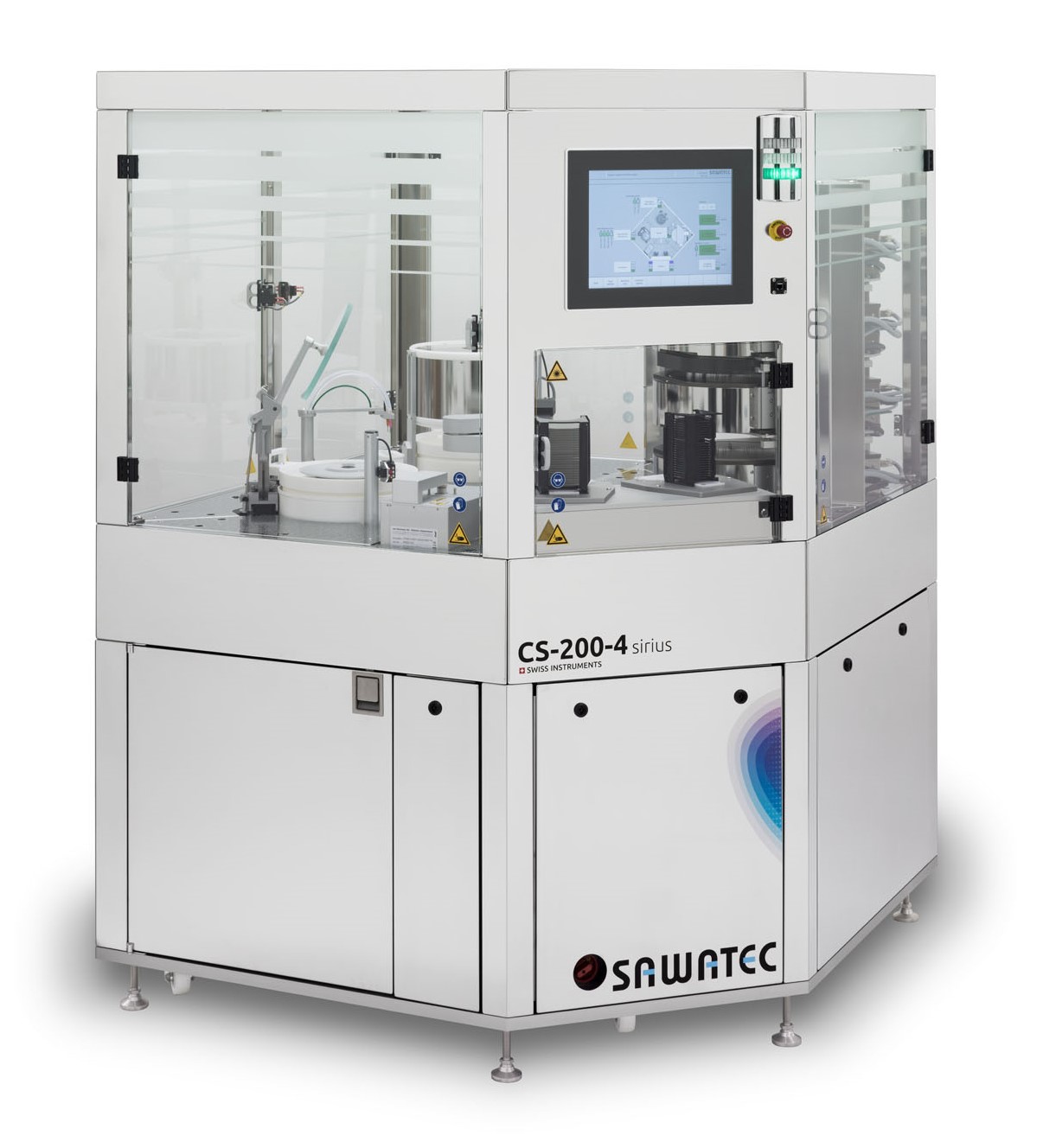
SAWATEC 旋涂机与热板组合系统 — 涂胶与烘烤一体化解决方案
引言:烘烤——光刻工艺中被低估的关键环节
在半导体光刻工艺链中,烘烤(Baking)是贯穿始终的核心热处理步骤。从涂胶后的软烘(Soft Bake)到曝光后烘烤(Post-Exposure Bake, PEB),再到显影后的硬烘(Hard Bake),每一步的温度精度和均匀性都直接影响光刻胶的化学与物理特性,进而决定最终图形的关键尺寸(CD)、侧壁形貌和工艺良率。然而,烘烤环节的重要性常常被忽视——直到温度偏差导致良率下降时,工程师才意识到问题的根源。
一、软烘(Soft Bake):光刻胶成膜的第一步
1. 软烘的作用
软烘是在光刻胶涂覆后、曝光前进行的加热步骤,其主要目的包括:
- 溶剂去除:蒸发光刻胶中残留的溶剂(通常去除80-90%),使胶膜从液态转变为固态薄膜
- 改善附着力:促进光刻胶与基片表面的粘附,防止后续工艺中的剥离
- 降低薄膜应力:缓解旋涂过程中产生的内应力,减少裂纹和缺陷
- 稳定膜厚:使光刻胶膜厚在曝光前达到稳定状态
典型的软烘温度范围为90-110°C,烘烤时间60-120秒。温度过低会导致溶剂残留过多,影响曝光灵敏度;温度过高则可能引发光刻胶中感光成分的热分解,同样损害成像质量。
2. 软烘的工艺要求
软烘对温度均匀性的要求虽然不如PEB严格,但仍需控制在±0.5°C以内。不均匀的软烘会导致基片不同区域的溶剂含量差异,进而表现为曝光后CD的系统性偏差。对于化学放大光刻胶(CAR),软烘的影响更为显著,因为残留溶剂会影响光酸的扩散行为。
二、曝光后烘烤(PEB):精度要求最高的烘烤步骤
PEB是化学放大光刻胶工艺中最关键的烘烤步骤。曝光产生的光酸在PEB过程中催化脱保护反应,决定了曝光区域与非曝光区域的溶解度差异。PEB温度每偏差1°C,可能导致CD变化达10 nm——这在先进制程中是不可接受的。因此,PEB对热板的温度精度和均匀性提出了最苛刻的要求:精度需达到±0.3°C甚至更优。
三、硬烘(Hard Bake):图形固化与增强
1. 硬烘的作用
硬烘在显影完成后进行,其目的是:
- 进一步去除残留溶剂和水分:提高光刻胶膜的致密度
- 增强光刻胶的抗蚀刻能力:通过热交联反应提高胶膜的化学和机械稳定性
- 改善图形侧壁形貌:适度的热回流可以平滑粗糙的侧壁
- 提高附着力:增强光刻胶与基片在后续湿法或干法蚀刻中的粘附力
硬烘温度通常为120-200°C,部分特殊工艺(如聚酰亚胺固化)可能需要250°C以上。与软烘相比,硬烘温度更高、时间更长,但对均匀性的要求因应用而异。
2. 软烘与硬烘的核心区别
| 参数 | 软烘(Soft Bake) | 硬烘(Hard Bake) |
|---|---|---|
| 工艺位置 | 涂胶后、曝光前 | 显影后 |
| 温度范围 | 90-110°C | 120-200°C+ |
| 主要目的 | 溶剂去除、成膜 | 固化增强、抗蚀刻 |
| 均匀性要求 | ±0.5°C | ±0.5-1.0°C |
| 时间 | 60-120秒 | 2-30分钟 |

SAWATEC SBM-98 热板 — 紧凑型台面式设计,适用于实验室环境
四、温度均匀性:决定光刻质量的隐形因素
1. 温度不均匀的后果
热板表面的温度分布直接映射到光刻胶的化学反应程度。温度偏高的区域反应过度,温度偏低的区域反应不足,最终导致:
- CD(关键尺寸)在晶圆面内出现系统性偏差
- 膜厚均匀性恶化
- 显影窗口缩小,工艺容错性降低
- 批次间一致性变差
2. 多区加热技术
为实现高温度均匀性,现代热板采用多区独立加热控制设计。SAWATEC HP系列采用多达9个独立加热区,每个区域配备独立的加热元件和温度传感器,通过PID算法实现±0.3°C的全面精度。这种设计有效补偿了热板边缘的散热损失,确保从中心到边缘的温度一致性。
五、关键温控参数详解
1. 升温曲线(Ramp Profile)
可编程的多步升温曲线对于敏感材料至关重要。急剧升温可能导致光刻胶表面快速固化而内部溶剂未充分挥发("结皮效应"),影响后续曝光和显影质量。SAWATEC HP系列支持多达24步温度编程,工程师可以设计缓慢升温→恒温保持→缓慢降温的完整温度剖面,最大限度地减少热应力。
2. Proximity Pins(间隙针)
Proximity pins是热板表面的微型支撑针,使基片悬浮在热板上方一定高度(通常0.1-1.0 mm),而非直接接触。这种设计的优势包括:
- 避免背面污染:基片背面不直接接触热板表面
- 改善温度均匀性:通过气隙传热实现更均匀的热分布
- 保护基片:减少翘曲基片接触热板时产生的应力
SAWATEC HP系列提供高度可调的proximity pins(0.1 mm增量),使工程师能够针对不同基片厚度和材料优化间隙高度。
3. 真空固定(Vacuum Chuck)
对于薄基片或翘曲严重的晶圆,真空吸附系统可以将基片平整地固定在热板上,确保整个基片表面与热板保持一致的间距。SAWATEC HP系列可选配真空固定功能,特别适用于150 μm以下的薄晶圆和柔性基板的烘烤工艺。
六、不同基片尺寸的烘烤方案
SAWATEC HP系列针对不同基片尺寸提供了专门优化的热板方案:
- HP-150:适用于150 mm(6英寸)晶圆,研发和小批量生产的理想选择
- HP-200:适用于200 mm(8英寸)晶圆,9区加热设计,温度精度±0.3°C,覆盖MEMS、功率器件和化合物半导体等主流应用
- HP-300:适用于300 mm(12英寸)晶圆,面向先进制程和大规模量产需求
所有型号均支持室温至250°C的标准温度范围,高温版本可扩展至300°C以上。电动升降装载系统和机械手接口支持全自动化集成。

SAWATEC ROBO 自动化系统:HP-160 三联热板 + ROBO 机械臂 + SM-200 旋涂机,实现全自动涂胶烘烤流程
七、SAWATEC HP 系列的技术优势
- ±0.3°C 全面温度精度:9区独立PID控制,满足PEB等高精度烘烤需求
- 24步可编程温度曲线:灵活定义升温、保温、降温过程
- 可调Proximity Pins:0.1 mm增量调节,适配各种基片类型
- 真空固定选项:确保薄基片和翘曲晶圆的烘烤质量
- 150-300 mm全尺寸覆盖:统一平台架构,降低学习和维护成本
- 瑞士精密制造:全球超过1500台装机量验证的长期可靠性
- 集群系统集成:可无缝集成至SAWATEC CS集群系统,实现涂胶-烘烤-显影全流程自动化
总结
烘烤工艺贯穿光刻全流程,是影响CD控制、膜厚均匀性和工艺良率的关键因素。选择一台温度精度高、均匀性好、编程灵活的热板设备,是确保光刻工艺稳定性的基础。SAWATEC HP系列以±0.3°C的温度精度和多区独立控制技术,为从研发到量产的各种烘烤需求提供了可靠的解决方案。
如需了解更多关于SAWATEC HP系列热板的技术细节或申请工艺测试,欢迎联系我们的技术团队。
